Contact Information:
TAZMO Inc.
42840 Christy St.
Suite 103
Fremont, CA 94538
(510) 438-4890
eMail: Sales
eMail: Service
For our European partners, please visit www.teltec.com
|
|
| Back to Product Listing |
| |
| Single Spin Processor (SSP Series) |
Next generation wafer to wafer cleaning system |
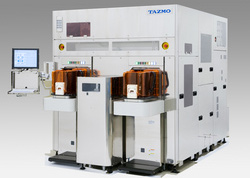 |
|
The SSP Series equipment is a new generation single wafer process cleaning system designed for precision cleaning and/or wet etching system for BEOL , FEOL 200mm, 300mm wafers. Each PM (process module) unit is isolated with a bulk-head wall design controlling the atmosphere with optimum air flow. Selection of top or top/bottom side processing capability along with 2 or 4 chamber selectivity is also available.
The SSP Series semiconductor cleaning system is designed for industrial cleaning and wet-etching of 300mm wafers. The system cleans before deposition of (High-k), polymer removal (Low-k), back-to-back etching or bevel etching. The closed chamber system controls oxygen concentration to ppb. The enclosed chamber prevents natural film oxidization on wafers and clean materials. The SSP is also designed for clean non-water solvent. |
| |
|
|
|
 |
 |
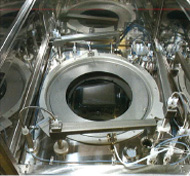 |
| Acid Chamber |
EFEM, Robot |
Organic Chamber |
|
|
|
Single wafer |
Batch type |
Cleanliness |
No cross contamination by single
Wafer processing |
Cross contamination from adjacent wafer appears |
Foot Print |
Small footprint is realized by using several kinds of cleaning fluids |
Large system required and using several kinds of cleaning fluids. |
Throughput |
Processing of over 300 wafers/Hr. |
|
Wafer backside Cleaning |
Applicable with backside nozzle and reverse mechanism |
Equal to surface cleaning |
Bevel care |
Applicable
Wrapping control is possible |
Not applicable
Wrapping control not possible |
Drying Method |
Spin dry
Rotagoni drying (IPA)
Measurement of water mark is necessary at water repellent surface(bare Si, Low-k) |
Spin dry is required
Marangoni drying (IPA)
Measurement of water mark is necessary at water repellent surface(bare Si, Low-k) |
|
| |
| top |
|
|
|